1、半导体器件的生成:电阻器、电容器、二极管、晶体管、熔断器、导体;
2、电阻器:掺杂型电阻器、EPI电阻器、Pinch电阻器、薄膜电阻器;
3、电容器:氧化硅电容器、结电容器、沟槽电容器、堆叠电容器(stacked capacitor);
4、二极管:掺杂二极管(击穿电压breakdown)、Schottky barrier二极管(欧姆接触);
5、晶体管:双极型晶体管(transfer resistor)、Schottky barrier双极型晶体管;
6、场效应晶体管(FET):金属栅型MOS场效应晶体管、硅栅极型MOS、多晶硅栅型MOS、硅化物栅极型MOS、V凹槽型MOS(VMOS)、扩散型MOS(DMOS)、存储器MOS(MMOS)、结型场效应晶体管(JFET)、金属半导体场效应晶体管(MESFET);
7、熔断器和导体:(underpass conductor 地下导体); 全文 »
1、制造和工厂经济:
尽管有在工艺、成本以及市场方面的诸多变化,衡量芯片制造领域的财政状况的方法依然相同:即对于芯片厂售出的有功能的芯片,每片的成本如何(the cost per functioning die shipped out of fabrication)等;在因拥有了封装能力而完全扩展为商业工厂后,衡量方式又变成每一片售出的芯片成本(the cost per die shipped);在百万级的集成电路世界,每个晶体管的成本正成为一个指示参数。
2、晶圆的制造成本:
a.固定成本:
■管理费用(行政人员数量增长快于生产人员;工厂设施成本及设施维护费用等)
■设备(折旧)
b.非固定成本
■材料:直接材料(进入到芯片中或加在芯片上的材料)和非直接材料(掩膜版等化学品)
■劳动力:直接劳动力和非直接劳动力
■良品率:有良品率的芯片成本(yielded die cost)和未有良品率的芯片成本(unyield die cost)
3、生产成本因素:
a.300毫米直径的晶圆成本估算: 折旧35% 劳动力7% 维护7% 消耗品(直接材料12% 测试晶圆6% 非直接材料26%) 其他7%
b.账面-单据(book to bill)比率
c.生产策略
d.污染控制系统 全文 »
《芯片制造工艺制程实用教程》看得也差不多了,正好在今天的邮件中收到了《半导体科技》杂志社的2008集成电路制造工艺流程图,几乎囊括了书中所有的工艺流程,并且将各个配套的设备材料供应商也列举上去了。另外还有关于我国IC封测商及工艺的一些整理结果,点击下面的文字和图片链接就可以看到相应详细内容了!
| 我国150mm-300尺寸IC生产线结构 | 中国内地主要封测厂商(按所属地区划分) |
周末在家研读了namics公司的又一篇关于underfill的文章《Under-fill Technology Roadmap for SIP Fine-pitch Flip Chip》,其实整篇文章后面有一般也探讨了ACP NCP等异向导电材料和非导电材料等在IC封装中的一些应用,就文中内容整理如下:
1、作为Core technology of underfill for SIP涉及到以下几点:
Fine pitch & Narrow gap(Fine filler distribution)
No void(Dispersion Technology)
Narrow space dispensing (Jet Dispensing)
Stack, thin die, High density PKG(Minimized Bleeding and Creeping)
2、其中的一个基本结论是选择0.1-0.3um直径的填料是最能适应各类间隙(gap)元件的底部填充工艺的;如果填料产生团聚等现象会导致 全文 »
1、从工艺控制和改进的观点来看,关于测量的收集分为三大类:一是包括对测试晶圆和实际器件电性的测量;二是直接测量某些物理参数例如层的厚度、宽度、组成等等;三是测量晶圆和材料内部的污染;
2、晶圆的电性测量:
a.电阻和电阻率及其测量:四探针测试仪(还可测试方块电阻及导电层厚度)
b.掺杂浓度、深度图解法(扩散电阻、阳极氧化技术)
c.二次离子质谱法(SIMS)
d.差动霍尔效应(DHE)
e.氧化层击穿(BVox或击穿电压、GOI)
f.物理测试方法(FIB)
3、晶圆层厚的测量:
a.颜色(由透明镀膜材料的反射系数、观察角度和镀膜的厚度决定)
b.条纹法
c.分光光度计/反射系数
d.椭偏仪
e.触针
4、晶圆的结深:
a.凹槽和斑点(刻蚀技术和点解斑点)
b.扫描电镜(SEM)厚度测量
c.扩散电阻测试法(SRP)
d.二次离子质谱法(SIM)
e.扫描电容显微镜(SCM)及原子力显微镜(AFM) 全文 »
前几日在国外的一个通讯论坛GSM-Forum(http://forum.gsmhosting.com/vbb/index.php)上面下载了一份关于underfill返修的技术资料,一直没有时间细看,近日抽空学习了一遍。这是一份motorola公司内部的关于Repair Methods的操作规程,是2007年的版本,此资料图文并茂的阐述了几种不同情况下的返修,包括普通元器件的返修、BGA的返修、POP的返修,其中后两者的返修涵盖了使用underfill或者underfirm(underfilm?)的情况,然后还介绍了自制的空气冷却系统DIY Air Cooling System、替代3M隔热胶带的经济实用的方法Heat Shielding Methods,以及整个过程中使用的设备、工具、材料等等,具体内容大家可先参看以下目录再决定是否需要下载查看:
Table of Contents
1.0 Introduction 4
1.1 Scope 4
1.2 Terms And Acronyms 4
1.3 Safety and ESD Precautions 4
1.4 Housekeeping 4
2.0 Lead Free 5
2.1 Equipment/Tools Set-up 5
2.2 Procedures 6
2.2.1 Removal of SMD Components 6
2.2.2 Removal of BGA Components 6
2.2.3 Placement of BGA Components 7 全文 »
这又是一份namics公司撰写的关于底部填充过程中空洞(气泡)产生的原因及避免的方法的,其中是以其U8439-1型号为例进行分析的。关于空洞(气泡)产生的原因可以总结为两大类,一类是叫Capture void,一类是叫Volatile void。用中文理解就是一类是捕获空洞(气泡)?一类是挥发产生的空洞(气泡)。前面这个Capture void表达可能不够确切,但一时也想不起更好的表达方法。
关于Capture void的产生主要是因为点胶Filleting speed速度大于其在芯片底部的填充速度penetration speed,导致空气无法排出,结果导致空洞的形成,如图所示:

解决的方法就是让The Filleting speed = The penetration speed,采取的措施就是: 全文 »
1、虽然掺杂的区域和PN结形成电路中的有源元件,但是需要各种其它的半导体、绝缘介质和导电层完成器件/电路的电器性能,其中的一些是通过化学气相淀积CVD和物理气相淀积PVD的方式淀积在晶圆的表面;常规的淀积层有:掺杂的硅层(外延层)、金属间的绝缘介质层(IMD)、金属间的导电连线、金属导体层和最后的钝化层;半导体薄膜的参数:
■厚度/均匀性;(高纵横比模式)
■表面平整度/粗糙度;
■组成/核粒(grain)尺寸;
■自由应力;
■纯净度;
■完整性;
■电容;(金属传导层-高传导、低电阻低电容的低k介质;绝缘介质-高电容或高k值介质)
关于low-k值和high-k值可参看另一篇日志:什么是Low-K?什么是High-K?
2、化学气相淀积CVD基础:
a.淀积(deposition)指一种材料以物理的方式沉积在晶圆表面上的工艺过程,而生长膜是从晶圆表面的材料上生长形成的; 全文 »
1、结的定义:结(junction)就是富含电子区域(N型区)与富含空穴区域(P型区)的分界处,具体位置就是电子浓度和空穴浓度相同的地方,靠热扩散或离子注入可形成结;
2、掺杂区和结的扩散形成:
a.扩散:是一种材料通过另一种材料的运动,是一种自然的化学过程。两个必要条件一是一种材料的浓度必须高于另外一种材料的浓度,其次是系统内部必须有足够的能量使高浓度的材料进入或通过另一种材料;
b.NP结:掺杂区中N型原子的浓度较高,反之PN结掺杂区中P型原子的浓度较高;
c.扩散工艺的目的:
■在晶圆表面产生具体掺杂原子的数量(浓度);
■在晶圆表面下的特定位置处形成NP(或)PN结;
■在晶圆表面层形成特定的掺杂原子(浓度)分布。
d.横向(lateral)或侧向(side)扩散、同型掺杂(不会形成结);
e.结的图形显示、浓度随深度变化的曲线;
3、扩散工艺的步骤:固态扩散工艺(solid-state diffusion)形成结需要两步:淀积(deposition)和推进氧化(drive-in-oxidation),均在水平或垂直的炉管中进行。 全文 »
此文转自中国电子胶水论坛http://www.r4e.cn/bbs/thread-8011-1-1.html
弱弱的问一个问题?环氧胶里面,有属于环保节能的吗?如果有,指的是那个呢?
个人理解环保可能就指类似符合ROHS、无卤、PFOS、POHS等欧盟对电子材料的环保新要求的环氧;
而节能的话可以这样理解:同等固化温度下更短的固化时间或者同等固化时间下更低的固化温度(一般指热固化),这样可以节省(热能)电能,呵呵!
所以国内很多厂家尤其是电子厂家对快速固化或低温固化比较热衷,即使工艺上并没有如此严格温度和时间的要求(要看当初是如何配置生产线产能的),而变相的成为了一种胶水厂商竞争的由头!
举一个真实的例子: 全文 »














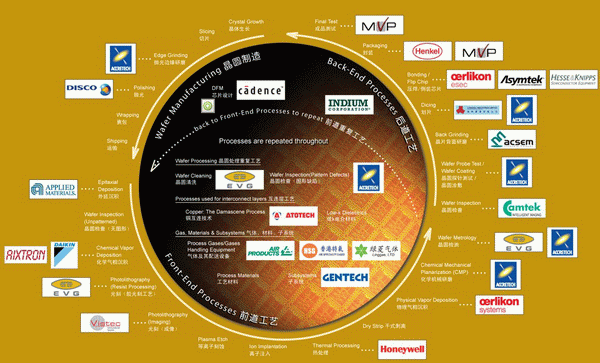
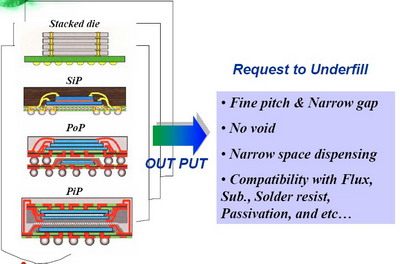



《【扒一扒】日本高纯球形硅微粉材料生产商》: 作为一种无机非金属矿物功能性粉体材料,硅微粉广泛应用于电子材料、电工绝缘材料、胶黏剂、特种陶瓷、精密铸造、油漆涂料、油墨、硅橡胶等领域。 目前,世界上只有中国、日本、韩国、美国等少数国家具备硅微粉生产能力... 全文 ?