第八章 结构胶粘剂的化学性质和物理性能
1、结构胶粘剂(structural adhesive):这是一种用于粘接高强度材料(如木材、复合材料或金属)的胶粘剂,室温下其实际粘结强度大于6.9MPa(1000psi)。另一种定义:这是一种在有效设计荷载下不发生形变(或蠕变)的材料。由于性能的要求,结构胶粘剂通常是一些可交联的(热固性的)有机化合物,经常带有极性,具有很高的表面能,能够抵抗多种类型的外界破坏,在恶劣环境中经受若干年甚至数十年;
2、膜状胶粘剂-film adhesive 膏状胶粘剂-paste adhesive
3、结构胶粘剂基体树脂的化学性质:
1).酚醛树脂:
a.碱为催化剂,苯酚与过量甲醛反应制得甲阶酚醛树脂(resole phenolic resin);酸为催化剂,甲醛与过量苯酚反应制得线型酚醛树脂(novolac phenolic resin)+六亚甲基四胺(Hexa 乌洛托品)可固化;
b.苯酚与甲醛以2:1的物质的量的比进行反应时,得到的产物被称为双酚F(二苯酚甲醛),当苯酚与丙酮以同样的物质的量的比进行反应时,则会得到双酚A(二苯酚丙酮);
2).蛋白质:
用于结构胶粘剂的蛋白质主要来源有动物血、鱼、奶、连接组织和大豆等。纵观历史蛋白质类胶粘剂一直被人类所使用,在现代主要用于胶合板的生产,但其不能经受恶劣的环境,所以她制得的胶合板只能局限于室内使用; 全文 »
第五章 污染控制
1、半导体器件极易受到多种污染物的损害:微粒、金属离子、化学物质、细菌;
微粒:1cm=10000um, 人的头发直径约为100um,微粒的大小要小于器件上最小特征图形尺寸的1/10 倍;(1994年SIA将0.18um设计的光刻操作的缺陷密度定为0.06um下的135个)
金属离子:可移动离子污染物(MIC),Na是最常见之一;化学品:以氯为代表;
2、污染引起的问题:器件工艺良品率、器件性能、器件可靠性;
3、污染源:空气、厂务设备、洁净室工作人员、工艺使用水、工艺化学溶液、工艺化学气体、静电;
4、空气
a.空气洁净等级标准209E:区域中空气级别数是指在一立方英尺(0.0283立方米)中所含直径为0.5微米或更大的颗粒总数。一般城市空气为500万级; 全文 »
今天抽空看了一篇专业论文《應用異方性導電膠於覆晶構裝中之熱行為分析研究》,是由台湾大葉大學機械工程學系暨研究所的鄭江河 莊賀喬 趙容適 鍾培原四位合著的,说句实话是一篇纯研究性的文章,看得也不是太懂,主要是通过一些模型对相关材料的热行为进行分析。不过一个收获就是在此文章中提到了异向导电胶的一个参数-泊松比,在传统的胶黏剂论文里面很少有涉及到这个的。这个概念我也是在前面学些《粘接与胶黏剂技术导论》时见过,参看http://www.g4e.cn/wordpress/?p=57。
在此在复习一下泊松比的概念:◆泊松比(Poisson’s ratio) υ=(r0-r)/r0/ε 表示材料在拉伸应力作用下的细化程度-横向应变与拉伸应变的比值(多数各向同性isotropic materials材料泊松比接近0.25,上限为0.5)
下面是该论文的摘要,敢兴趣的朋友可以下载附件查看一下全文资料: 全文 »
近日又碰到乐泰一款3512型号的underfill产品,目前接触到的351系列的乐泰underfill有3512 3513 3517等,其实看了这几款的产品的技术资料都是很类似的,严格上来讲好像是3513比较支持快速固化或者称之为回流固化的工艺,而其他几款均是需要在烘箱中进行固化的。 看了一遍3512的技术资料发现一个小问题,该产品固化前比重为1.2,固化后密度为仍为1.2,而其体积收缩率Shrinkage却有2.8%,按我以前的理解此收缩率是由固化前后密度差算出来的,这样的话在这里就行不通了。再看了一下3513的固化前后比重和密度为1.15和1.18,那算出来的体积收缩率应该是2.54%,而其TDS显示也是2.5%,然后再看了一下3517的固化前后比重和密度为1.13和1.16,那算出来的体积收缩率应该是2.65%,其TDS显示为2.7%,都还算比较接近的。但3512这里这个参数可能需要商榷一下了。当然这只是折算Shrinkage的方法之一,其中的差异可能也是测试方法导致的!
还有3512和3513最大的差异是其属于不可返修型underfill
下面贴一些3512的基本技术资料,大家参考一下,也可下载附件查看3512和3513的TDS技术资料:
LOCTITE 3512 provides the following product characteristics: 全文 »
第四章 芯片制造概述
1、芯片制造的四个阶段:原料制作-单晶生长-晶圆制造、集成电路晶圆的生产(wafer fabrication)-集成电路的封装;
2、晶圆术语:
器件或叫芯片-Chip、die、device、circuit、microchip、bar
街区或锯切线-Scribe lines、saw lines、streets、avenues
工程试验芯片-Engineering die、test die
边缘芯片-Edge die
晶圆的晶面-Wafer Crystal Plane
晶圆切面/凹槽-Wafer flats/notche
3、晶圆生产的基础工艺:增层-光刻-掺杂-热处理
4、电路设计:功能电路图(逻辑功能图)-示意图-电路版面设计(复合图composite)
5、光刻母版(reticle)和掩膜版:光刻母版是在玻璃或石英板的镀薄膜铬层上生成分层设计电路图的复制图。
6、晶圆测试:又称芯片测试(die sort)或晶圆电测(electrical sort)
第七章 被粘物的表面处理
1、金属表面:由外而内-吸附的气体、吸附的极性有机物、吸附的非极性有机物、吸附的水、金属氧化物、金属;
2、如何获得更好的粘接表面:第一需要除去低分子基础物的弱边界层,第二需要提高弱边界层的表面能;第三改变聚合物表面形态,促使胶粘剂毛细管作用产生;
2、塑料的表面处理:
电晕放电处理(CDT)-聚乙烯PE、聚丙烯PP、聚对苯二甲酸乙二酯PET、其他材料
表面化学官能化(surface chemical functionalization)、二异丙氧基钛双乙酰丙酮(DPTAA)、低分子量氧化物(low molecular weight oxidized material)LMWOM、水膜残迹法(water break)、氟化的乙烯-丙烯共聚物(FEP)
火焰处理-聚烯烃、聚乙烯PE、聚丙烯PP、苯乙烯-丁二烯橡胶
等离子处理-PE的等离子处理、其他基材的等离子处理
CASING(crosslinking by activated species of inert gases)表示惰性气体中活性组分引起的交联。
聚合物表面其它的物理处理法-紫外线辐射处理、表面处理的其他真空方法(离子束蚀刻和射频溅射蚀刻)
聚合物表面处理的湿化学方法-在聚合物表面施用溶液以清洁物体表面或制备实际表面,最简单的方法就是用溶剂擦拭、还有就是涂层。PE的单一表面化学官能化和铬酸处理、聚四氟乙烯(PFTE)的湿化学表面处理;
聚合物表面涂底胶处理-(priming),用于氰基丙烯酸酯和聚烯烃涂底胶处理、氯化聚烯烃; 全文 »
本文摘自中国电子胶水论坛精华帖http://www.r4e.cn/bbs/thread-7862-1-1.html, 由“洋梨果”版主所发表,一篇比较有概括性的文章,大家共同学习之!
银粉银浆市场状况
一.
前言
银有如下几方面特性:
最优常温导电性
最优导热性
最强的反射特性
感光成像特性
抗菌消炎特性
全文 »
今天有位朋友向我咨询到乐泰的一款underfill产品,型号是3517,据说是用在sharp的PDA类产品上面,我对3513了解多一些,因为碰到的手机客户用此款的较多,公司的DU901和DU902也都是针对3513同类应用的。于是去官方网站下载了一份看了看!看上去与3513还比较类似,不过固化的温度似乎可以更低一些,时间也稍微长一些,还有就是Tg点似乎要高一些,但返修方式好像是一样的。
LOCTITE 3517 is a one part, heat curable epoxy. It is designed for use as a reworkable CSP(FBGA) or BGA underfill for protection of solder joint against mechanical stress when used for hand held electronics devices.
Chemical Type: Epoxy
Appearance (uncured): Black liquidLMS
Components :One component – requires no mixing
Cure: Heat cure
Cure Benefit :Production – high speed curing
Application :Underfill
Specific Application :Reworkable underfill for CSP (FBGA) or BGA
Dispense Method :Syringe
Key Substrates: SMD components to PCB
Reworkable: Yes
有兴趣的朋友可以下载学习一下! 华为网盘下载 http://dl.dbank.com/c08ln0au3h
3517-en
第六章 表面科学与粘接科学的关系
1、粘接的静电理论:倡导者-Derjaguin,假定了Ec=Wb,没有考虑剥离时消耗的能量并不是界面能,忽略了胶粘剂和被粘物的塑性变形,只有单被粘物和胶粘剂是完全弹性体的情况下,界面能才是破坏胶接件的总能量;(只有当相互接触的材料间存在着巨大的电负性差异时,静电力才会在粘结的形成中发挥作用,决定交接件的强度)
电负性-electronegativity;断口放射-fracto-emission
2、粘结的扩散理论(挑选与被粘物相溶的胶粘剂):扩散粘接使人们不可能得到真实的界面,而是一个中间相,在这个相中材料A逐渐变成材料B的特性。扩散粘接使粘接的极限结果。被粘物和胶粘剂间互溶的情形很少,因此扩散理论只能应用于有限的情况,以Hildebrand提出的真溶液理论为基础,可以为材料的互溶性提供一些判据。Iyengar&Erickson实验;双悬臂梁测试方法;
内聚能Ecoh(cohesive energy)、PET-聚对苯二甲酸乙二酯、自粘性(autohesion)、嵌段共聚物(block copolymers)、PMMA-聚甲基丙烯酸甲酯、PS-聚苯乙烯、PI-聚戊二烯、分子链拉出(chain pullout)、蛇行理论(reptation theory) 全文 »
今日看了一篇讲义《高良率RFID电子标签量产技术》,是2007 RFID Summits in Taiwan上面由资贸科技股份有限公司(AMOS Technologies Inc.)的杜德霖先生撰写演讲的《A professional RFID tagmanufacturer and solutions provider》。其实对于RFID的相关应用我之前很少完整的看过一些资料或文献,都是零散的一些内容,所以看这篇讲义时很多地方也是一知半解,或许需要综合更多的基础知识才能理解得更深入一些。不过就看完的内容大致总结一下学习的体会:
存在的困难还是依然,天线的印制、芯片的粘接等等一直是几种方式并存,不过里面谈到了制造的风险,截图如下,应该算是一个比较全面的归纳,当然有没有公司倾向性就不得而知了,见图:
全文 »














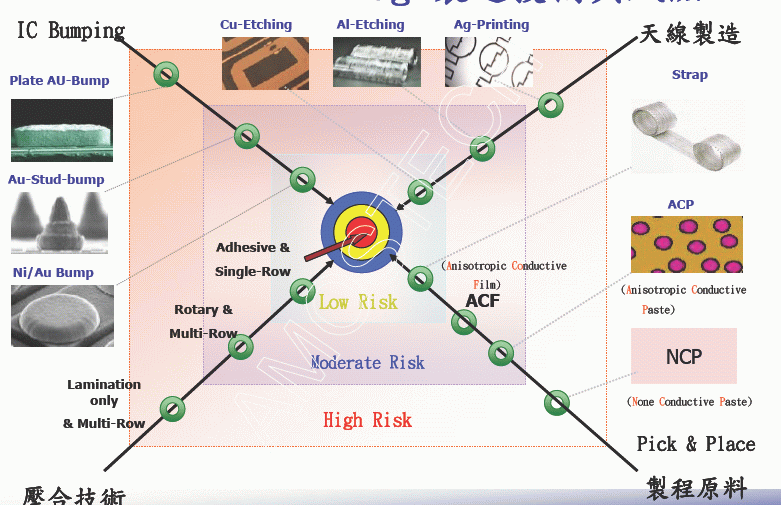



《【扒一扒】日本高纯球形硅微粉材料生产商》: 作为一种无机非金属矿物功能性粉体材料,硅微粉广泛应用于电子材料、电工绝缘材料、胶黏剂、特种陶瓷、精密铸造、油漆涂料、油墨、硅橡胶等领域。 目前,世界上只有中国、日本、韩国、美国等少数国家具备硅微粉生产能力... 全文 ?