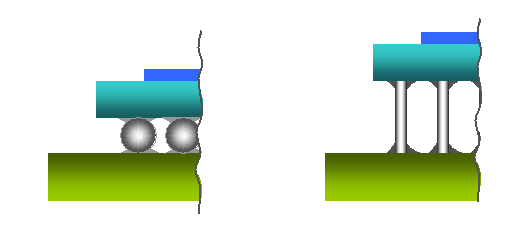 今日学习了一篇同事给我的关于底部填充材料的返修的资料,看完发现这个实际是针对CGA下面使用的underfill进行的介绍,与目前在BGA下面使用的材料类似,文中对比了三款不同的胶水的实验结果,Thermoset: ME526 (Red) – Locktite: 3567 (Cream) – Dexter: FP 4511 (Black)。最终的结论似乎是FP4511是最理想的,由于不知道CGA和BGA材质的差别,所以其对胶水的要求的重点似乎不大清楚。另外CGA似乎在民用电子产品中的应用好像比较有限,想必关注的人也不多,不过看看多少是有些帮助的,有兴趣的同学可以下载下来看看,不过这份文件也比较早,好像是2001年左右的,另外查了一下作者的情况,似乎是NASA(美国国家航空航天局)的相关人员,印象中CGA等一些特殊封装的元器件的确是在一些高端的领域应用的!
今日学习了一篇同事给我的关于底部填充材料的返修的资料,看完发现这个实际是针对CGA下面使用的underfill进行的介绍,与目前在BGA下面使用的材料类似,文中对比了三款不同的胶水的实验结果,Thermoset: ME526 (Red) – Locktite: 3567 (Cream) – Dexter: FP 4511 (Black)。最终的结论似乎是FP4511是最理想的,由于不知道CGA和BGA材质的差别,所以其对胶水的要求的重点似乎不大清楚。另外CGA似乎在民用电子产品中的应用好像比较有限,想必关注的人也不多,不过看看多少是有些帮助的,有兴趣的同学可以下载下来看看,不过这份文件也比较早,好像是2001年左右的,另外查了一下作者的情况,似乎是NASA(美国国家航空航天局)的相关人员,印象中CGA等一些特殊封装的元器件的确是在一些高端的领域应用的!
Reworkability of Underfill Materials
NEPP Deliverable
Jong Kadesch
Harry Shaw
Outline
Objective
• Procurement
– underfill material, and two rigid boards (one with pins, and one
without pins)
• Assembly Process
– Mate two rigid boards using conductive epoxy
– Column Grid Array (CGA) interconnection
– Fill with underfill around CGA interface
• Test Plan
– temperature cycles
– Destructive Physical Analysis (DPA)
• Removal Method Experiment
……
下载附件查看PDF 全文














联系站长
Email:Anndiqiu#Gmail.com
Mobile Phone:13923499497
热门文章
数字
$2,242.7 Million Explore Global laminating adhesives market that is poised to be worth $2,242.7 million by 2019 了解更多 »