我这里所说的底部填充胶之测试技术主要是站在客户角度的,至于UNDERFILL研发过程中考虑的因素会更多一些,但与客户的实际评估又有着许多不同的地方,虽然某些指标和客户的测试技术是相关的,但实际中往往是综合因素的影响,所以要了解客户的核心需求才能对应提供合适的产品。另外在UNDERFILL的理论研究中(论文什么的)就考虑考虑得更细了,其中还用了很多数学、物理及化学的模型及函数来分析(中间还还涉及到表面张力、接触角,回归分析…),这个就更不在我们的讨论之列了。 全文 »
我这里所说的底部填充胶之测试技术主要是站在客户角度的,至于UNDERFILL研发过程中考虑的因素会更多一些,但与客户的实际评估又有着许多不同的地方,虽然某些指标和客户的测试技术是相关的,但实际中往往是综合因素的影响,所以要了解客户的核心需求才能对应提供合适的产品。另外在UNDERFILL的理论研究中(论文什么的)就考虑考虑得更细了,其中还用了很多数学、物理及化学的模型及函数来分析(中间还还涉及到表面张力、接触角,回归分析…),这个就更不在我们的讨论之列了。 全文 »
前面简介中以及提到过,UNDERFILL简单定义为“用于保护电子产品中某些芯片焊接后的锡球的一种胶粘剂”,所以理论上有锡球封装形式的电子元器件(BGA CSP FLIPCHIP……)等都可能使用到底部填充胶。而以上封装形式的元器件是为了迎合电子产品的轻薄小的需求而诞生的,而电子产品的轻薄小需求也是为了便于携带而诞生的。因为往往移动便携式电子产品中如果有用到有锡球封装形式的电子元器件时都有可能要用到底部填充胶水,这也是为什么上面讲胶水品牌时提到的都是智能手机厂商的使用。其实在其它一些领域也偶有底部填充胶的应用,但最终产品与手机的产量来说就望尘莫及了。所以这篇也是围绕常见的移动电子设备展开。 全文 »
严格意义上来讲,UNDERFILL产品本身并不会形成一个独立的品牌,它往往只是胶粘剂公司的某个系列的产品之一,而谈到品牌更多的应该是指生产UNDERFILL胶水的厂商,是指有着独立研发生产及应用并有着一定客户群的厂商。而且国内的很多(品牌)厂商之前也是拿别人的胶水(或配方)贴牌的,真正有着独立研发生产及应用的厂商其实并不是太多。我这里重点讲讲几家国外的厂商。
首先是德国汉高(HENKEL),或者说讲其旗下的子品牌乐泰(LOCTITE)大家可能更熟悉一些,其实汉高旗下还有爱默生康明(Emerson & Cuming)及HYSOL等一些品牌,它们曾经是有着UNDERFILL产品的。值得一提的是Emerson & Cuming,它在2007年左右被汉高收购,当时汉高收购的是帝国化工公司(ICI)旗下National Starch(国民淀粉)公司的粘合剂和电子材料业务部门,其中就包含了Emerson & Cuming及其旗下的一些子子品牌(Ablestick、Ablebond等)。 全文 »
UNDERFILL,中文名有很多:底部填充胶、底填胶、下填料、底部填充剂、底填剂、底填料、底充胶等等。其实从这个英文词来是Under和Fill两个词的组合,原本应该是一个动词,这是应用在这个领域逐步演变成了一个名词。其实用了几个在线的工具,翻译出来的结果都略有差异:最原始的翻译是Underfill [‘ʌndəfil] n. 未充满;填充不足。而上述的中文名基本上只能在网络释义或专业释义里查的,分别称为底部填充剂(谷歌翻译)、底部填充胶(金山词霸)及底部填充(百度翻译及有道翻译)。所以基本上称为底部填充剂(胶)应该是最贴近在电子行业实际应用中的名称。 全文 »
记得最开始接触电子胶水是从SMT贴片胶和COB邦定黑胶开始,那个时候并没有直接去参与销售,只是有其它的同事在销售和推广这些产品。那时的红胶还是刚刚在国内起步不久,基本上是美国乐泰的天下,后来日本富士的崛起,再后来就是国产的加入,但市场格局基本上在四五年前就基本定型了,剩下的所谓的竞争就是一些国产和伪进口的相互厮杀。 全文 »
初次接触乐泰的3536底填胶水是在2008年参与宇龙公司底填胶水竞标时,请参看此文 《LOCTITE 3536 UNDERFILL》。但是只知道此款产品有一个特性据说是可以经过二次回流,客户的理解就是耐热性比较好。 当时此款产品的技术资料也没找到,只是在网上截取了一个产品简介图片。 今天之所以又将此型号摘录下来,一来是因为近日发现此款产品也是属于乐泰公司不多的阳离子体系的底填胶水,大家参看附件的MSDS可略知一二,二来是因为近日参与了一家大公司的底填胶水评估,送了一款阳离子体系的胶水参与评估,表现不大理想。不过阳离子体系的底填胶水兼容性其实真的不大好,早期的有zymet公司的1703系列(那个时候乐泰还没有推出阳离子体系的underfill产品)。仔细的对比了一下乐泰官方版的TDS资料以及当时此产品刚推出时乐泰公司此型号彩页的参数,发现还是几个参数略有调整的,例如粘度、Tg、CTE的参数,也难怪但是乐泰一直没有发布官方的TDS资料了。 后来在网上找到了乐泰在2007年时的3536的内部TDS资料,及官网现在提供下载的TDS资料,这两者没什么区别的。 摘录2007年的TDS如下,有兴趣的朋友去下载附件查看原文:
PRODUCT DESCRIPTION
3536 is a CSP/BGA underfill that is designed to cure quickly at low temperature to minimize thermal stress to other components and provide rapid device throughput. When cured, it provides excellent protection for solder joints against mechanical stress, such as shock, drop, and vibration common in hand-held devices. The material is also reworkable, allowing for recovery of high-cost substrates and PWBs.
TYPICAL APPLICATIONS
Reworkable CSP/BGA Underfill.
PROPERTIES OF UNCURED MATERIAL
Typical Value
Chemical Type Epoxy
Appearance Black
Viscosity @ 25°C, mPas, 1,848
Brookfield, CP52/20
PHYSICAL PROPERTIES, CURED MATERIAL
Cure for 60min @ 120°C
Typical Value
Glass Transition, (Tg), °C, by TMA 53
Coefficient of Thermal Expansion cm/cm/°C,
α1 (<Tg) 63 x 10-6
α2 (>Tg) 178 x 10-6
Storage Modulus, GPa 3.5
GENERAL INFORMATION
For safe handling information on this product, consult the
Material Safety Data Sheet (MSDS).
Handling
Pot Life @ 25°C, days >14 days
(ITM10T), (time to double in viscosity)
Shelflife @ 2-8°C (estimated), months 6
Optimal Storage: 2-8ºC. Storage at lower than 2°C or higher than 8°C may adversely affect product properties. Material removed from containers may be contaminated during use. Do not return products to the original container. Henkel Corporation cannot assume responsibility for product which has been contaminated or stored under conditions other than those previously indicated. If additional information is required, please contact your local Technical Service Center or Customer Service Representative.
Substrate Preheat
For best results, substrate should be preheated (up to 70°C) to allow fast capillary flow.
Recommended Cure Conditions
5 min. @ 120°C
2 min. @ 130°C
Curing above 140°C is not recommended
Removal Procedure
The basic removal procedure for 3536 involves heating the underfill to approximately 240°C using a hot air nozzle on standard BGA rework equipment. This component is then twisted and removed. Residue removal is accomplished using a tacky flux or liquid flux and a solder removal vacuum tool.
NOTE
The data contained herein are furnished for information only and are believed to be reliable. We cannot assume responsibility for the results obtained by others over whose methods we have no control. It is the user’s responsibility to determine suitability for the user’s purpose of any production methods mentioned herein and to adopt such precautions as may be advisable for the protection of property and of persons against any hazards that may be involved in the handling and use thereof. In light of the foregoing, Henkel Corporation specifically disclaims all warranties expressed or implied, including warranties of merchantability or fitness for a particular purpose, arising from sale or use of Loctite Corporation’s products. Loctite Corporation specifically disclaims any liability for consequential or incidental damages of any kind, including lost profits. The discussion herein of various processes or compositions is not to be interpreted as representation that they are free from domination of patents owned by others or as a license under any Loctite Corporation patents that may cover such processes or compositions. We recommend that each prospective user test his proposed application before repetitive use, using this data as a guide. This product may be covered by one or more United States or foreign patents or patent applications.
最后发现了乐泰宣传资料及正式发布的TDS上一个显著的矛盾点, 宣传资料上显示回流炉固化条件可做到150度1分钟,而在正式发布的TDS固化条件中明确强调:“Curing above 140°C is not recommended”。的确阳离子体系产品固化温度过高会产生很多莫名其妙的问题,估计乐泰也是在和客户的配合过程中发现了这个问题,所以在资料里面做了修正。
华为网盘下载:
注册本地下载:
 3536 TDS&MSDS (126.1 KB, 17 次)
3536 TDS&MSDS (126.1 KB, 17 次)
您没有权限下载此文件。
今天有幸与一位世界级的底填胶UNDERFILL高人及另一位EMC领域资深的人士交流了一个上午,收获良多, 交流的信息量比较大,记录几个亮点与大家分享,在未征得他们同意前就不把他们的身份做明示,业内人士估计也能猜到一二。
1)这两位昨日刚在深圳某公司做了UNDERFILL的培训,大家感触一样,即便是行业的领先和佼佼者,某公司对底填材料或者说电子辅料的认知也不是特别深刻,好在某公司前两年开始建立材料可靠性试验室,对电子胶水、焊接材料、功能材料开始了专门的研究与分析,也开始与一些厂家和半政府性质的科研机构展开合作,在材料上做一些创新和突破(大家觉得唯有如此才有可能真正超越国外的竞争者);
2)关于汉高乐泰底填材料的演变,也是有着许多的故事,很多产品也是在早期给类似的NOKIA、MOTO等公司给“逼”出来的,而这几年推出的一些新型号类似UF3800、UF3801以及最新的UF3810也是给苹果等公司给“逼”出来的。中途也曾遭受过EMERSONCUMING的阻击,但通过收购解决了这个问题;
3)芯片级封装的UNDERFILL依旧被垄断,而PCB板级封装的UNDERFILL也是从其中演变而来,但由于使用者水平参差不齐,导致看上去的貌似百花齐放,而真正垄断市场的还是以汉高乐泰为主,不过国内外奋起直追者不少。中间谈到韩国元化学WON CHEMICAL的产品,这位高人也接触过,甚至当年去韩国三星多次“救驾”,在乐泰的3513系列产品被韩国元化学的WE-1007逐步替代的时候。不过发现这个也是替他人做了嫁衣(简言之就是韩国三星联合WON CHEMICAL一起在乐泰这里学了很多东西),导致乐泰底填产品全线从三星退出。中间还提到了SAMSUNG CHEIL(三星第一毛织)的unerfill,这个我也有印象,当时记得还帮他们把EL1200R卖给了当时的深圳天时达,不过UNDERFILL这个项目后来SAMSUNG CHEIL貌似放弃了。中间还提到了韩国的另一个公司但没记清楚。
4)每一次世界级公司的并购都会成就另外一些公司和个人, 一个现实的例子就是当初日本HYSOL被汉高收购的时候,他们的很多开发人员去了日本NAMICS,造就了NAMICS公司现在在芯片级UNDERFILL中的地位。不过当年汉高和国民淀粉电子部(EMERSONCUMING)的并购貌似也造成了尤其是乐泰电子部人员的动荡,包括研发和市场人员, 他们纷纷回国创业或者与国内本土企业合作,类似武汉晶丰、北京海斯迪克、烟台德邦等等公司都有他们的身影,还有部分人去了一些电子制造行业,例如前面提到的某公司等等。 当然还有这两位高人的公司(这里就不明示了)。相信随着他们的“回归”,国内应该很快可以成长起真正的高水准的电子胶水厂商(国内目前的胶粘剂龙头企业上市和准上市公司类似回天、硅宝、天山等其实都是在民用、建筑、工业胶粘剂颇有建树的,而电子胶水方面也都只是在开发阶段),请大家拭目以待!
5)透露一些“窃听”到的技术话题,研发的朋友可以关注一下哦,首先今天第一次听到关于胶粘剂ΔH值的概念,据说美国还有专门法规进行管控的,而类似很多配方的设计都是为了满足这个条件,而不光是为了操作性和功能性要求,这个值相信学过物理化学的朋友应该还是有印象的。但我个人估计国内做电子胶粘剂配方的研发人员估计没两个会考虑过这个参数的。另外交流中提到了美国一些化学公司为汉高乐泰专门开发的一些促进剂,谈到这里我更加佩服原来公司的时候UNDERFILL项目开发组的负责人曾工(ALEX ), 我相信他也是从化学原理角度找到这款分子式的物质,进而找到生产的产品的公司,而这个恰恰也是低粘度底填产品的最理想的促进剂之一。包括乐泰和EMERSONCUMING的一些配方中都有用到。 中间还提到了一些类似纳米核壳类的材料,这个我也是从曾工那里学习到的,所以有个同事戏称曾工为“流落民间的大内高手”真是一点也不为过,水平应该是超过了很多拿到硕士博士学位的人了。
6)今天信息量真的比较大,而且这位高手的语速奇快(很多搞技术的人好像都是这样的), 我一时半会消化不了,但对电子胶水行业的认知应该又会得到一个提升的,其中也探讨了很多关于行业的现状和发展的话题,这里就不再展开了。 碰巧今天在TWITTER上看到HENKEL公司发布的最新新闻《Henkel develops reworkable underfill》,是2012年3月12日发布的, 也难怪上午交流时说UF3800也快过时了,呵呵! 这个估计是最新的的产品UF3810。
最后就把这则新闻摘录如下,各位研发达人们,赶紧去研究研究吧,呵呵!
New product for high value electronic components
|
Expanding on its portfolio of advanced underfill materials, Henkel has developed Loctite UF3810, a new underfill technology that provides high reliability while also allowing for easier reworkability as compared to previous generation products.
|
||
| Download: web print |
In today’s electronic devices such as smartphones there are numerous complex engineering components. Expanding on its portfolio of advanced underfill materials, Henkel has developed Loctite UF3810, a new underfill technology that provides extremely high reliability while also enabling easier reworkability as compared to previous generation products. Ideally suited for today’s handheld communication and entertainment applications, Loctite UF3810 delivers excellent drop and shock protection.
Designed to deliver superior performance and ease-of-use, Loctite UF3810 addresses many of the complex requirements associated with today’s high value devices, but does so in a formulation that has excellent processability. The material is halogen-free, completely reworkable and has a high glass transition (Tg) temperature of 100°C, thereby delivering robust thermal cycling reliability for next-generation wafer-level CSP (WLCSP) and PoP devices. “Assembly specialists want to reliably protect these devices but also have the option to rework them should any issues arise”, explains Dr. Brian Toleno, Henkel’s Global Product Manager for Liquids. “Loctite UF3810 provides high reliability and reworkability – a balance not readily available with traditional, low Tg formulas”, says Toleno.
High-capacity at a cost-saving production process
With increasing device complexity comes increasing cost. Loctite UF3810 is the go-to product for manufacturers seeking high reliability in a cost-conscious formulation and improved thermal cycling reliability for fine-pitch (0.5mm pitch and below) area array devices. In addition to superior performance versus alternative reworkable underfills, Loctite UF3810 also provides ease-of-use that lends to its process flexibility. The material flows fast and underfills at room temperature and cures quickly at a moderate 130°C which, in addition to its halogen-free status, adds to the material’s sustainability through reduced energy consumption requirements.
These characteristics, in combination with its proven solder compatibility, make Loctite UF3810 a highly versatile, yet highly effective underfill system Besides the handheld market other industries can also profit from Henkel’s products. “Loctite UF3810 has also attracted the attention of those in the aerospace and automotive sectors, as it allows incorporation of CSP and PoP devices without any adverse impact to reliability,“ Toleno closes.
For more information on Loctite UF3810 or any of Henkel’s next-generation underfills, log ontowww.henkel.com/electronics.
Henkel AG & Co. KGaA
原文链接如下:http://www.henkel.com/news-2012-20120312-henkel-develops-reworkable-underfill-35160.htm
PRODUCT DESCRIPTION
LOCTITE® 3563™ provides the following product characteristics:
Technology Epoxy
Chemical Type Epoxy
Appearance (uncured) Off-white to beige liquidLMS
Components One component – requires no mixing
Cure Heat cure
Cure Benefit Production – high speed curing
Application Underfill for flip chip devices
Dispense Method Syringe
Key Substrates SMD components to PCB
Reworkable No
LOCTITE® 3563™ is a rapid curing, fast flowing, liquid epoxy designed for use as a capillary flow underfill for packaged ICs, such as CSPs and BGAs. Its rheology is designed to allow it to penetrate gaps as small as 25 μm. When fully cured, it minimizes induced stress at solder joint and thus improves thermal cycling performance.
TYPICAL PROPERTIES OF UNCURED MATERIAL
Specific Gravity@ 25 °C 1.52
Viscosity, Cone & Plate rheometer, 2 ° Cone, mPa·s (cP):
Temperature: 25 °C, Shear Rate: 5 s-1 5,000 to 12,000LMS
Temperature: 25 °C, Shear Rate: 20 s-1 5,000 to 12,000
Capillary Flow Rate, seconds:
Flow time, 100 °C, glass to glass, 25 μm:
6.35 mm flow ≤15
12.7 mm flow ≤45LMS
25.4 mm flow ≤150
VOC, ASTM D 3960, g/l <10
Moisture Content, ASTM D 4017, % 0.01
Total Volatile Content, ASTM D 2369, % <1
Filler Content, % 40
Particle Size, μm:
Average 1 to 2
Maximum <10
Pot life @ 22 °C, hours 8 to 12
Flash Point – See MSDS
Recommended Curing Conditions
>7 minutes @ 150 °C
>5 minutes @ 165 °C
Note: With all fast cure systems, the time required for cure depends on the rate of heating. Conditions where a hot plate or heat sink is used are optimum for fastest cure. Cure rates depend on the mass of material to be heated and intimate contact with the heat source. Use suggested cure conditions as general guidelines. Other cure conditions may yield satisfactory results. 全文 »
近日又了解到汉高旗下的一款底填胶的型号Hysol 3500,以前汉高的底填材料一般都是以乐泰品牌出现的,不知这款为何延用了Hysol的品牌,从TDS发布的时间来看是2009年2月份,也应该是在3548等的后面,与UF3800类似的时间推出的,这也是一款低粘度的产品,从TDS看与UF3800比较类似,一个特点是可以快速固化,固化条件是130度2分钟,另外它的Tg点也非常低,只有16度,其它的与传统underfill貌似差不多。摘录部分TDS中说明如下:
PRODUCT DESCRIPTION
3500™ provides the following product characteristics:
Technology Epoxy
Appearance Black
Cure Heat cure
Product Benefits • Snap curable
• Fast flow without substrate pre-heat
• Low temperature cure
• Dissipates stress on solder joints
• Reworkable
Application Underfill
Typical Assembly Applications Reworkable CSP/BGA
华为网盘下载:http://dl.dbank.com/c0lmy9amao
点击啊下载TDS资料:
 HYSOL 3500 UNDERFILL (66.5 KB, 286 次)
HYSOL 3500 UNDERFILL (66.5 KB, 286 次)
上个月接到上海国基电子,富士康旗下企业的技术人员关于POP封装用底部填充胶水的咨询,当时对此类封装的理解还停留在一级封装上面,以为POP封装是指在芯片级的应用,虽然以前就知道POP代表package on package的缩写,但一直没有具体了解过。所以当时对能用于此封装的underfill材料理解为类似namics提供的那种一道underfill。后面在网上查阅了相关资料,并前往上海国基电子公司现场与相关技术人员现场交流,才算了解相对多了一些。
关于POP封装的初步概念大家可以参看这个网址:http://en.wikipedia.org/wiki/Package_on_package。这里有一句比较有意思的话:It has been suggested that this article or section be merged with System in package. (意思是说POP封装某种意义上应该是SIP系统级封装的一种形式),关于SIP的文章文章比较多,大家用System in package为关键词在百度或谷歌里面就能搜索到很多文章。摘抄上述网址的部分内容参考:
Typical configurations
There are two widely used configurations for PoP:
1、 Pure memory stacking (two or more memory only packages are stacked on top of each other)
2、 Logic package in the bottom, memory package on top. For example, the bottom could be an application processor for a cell phone. The logic package goes on the bottom because it requires many more BGA connections to the motherboard.
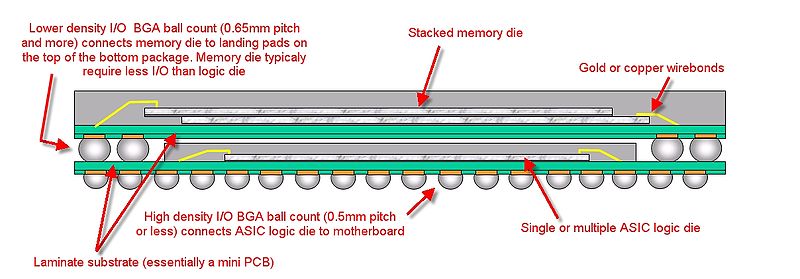
谈回到这个具体的案例,通过与国基工程师的交流,他们也是在评估此工艺,以前也没有接触过POP底填工艺。在去之前我们给他们推荐了韩国元化学WON的WE-1007NBLA,但是也没有在POP上成功实施的经验。他们目前经过评估暂定了Loctite公司的3536型号,据说是在POP上有成功的应用。其实3536之前我就有接触过,请参看此篇文章《LOCTITE 3536 UNDERFILL》。而之前接触的此材料实际上就是直接应用在二道secondary underfill里面的。据此而知POP上的underfill与传统的secondary underfill差异应该不大。但有两点需要注意的地方,首先其粘度不能太大,类似乐泰3515和韩国元化学的WE-1007NBLA的粘度都在4000cps左右, 两层同时填充的话估计有一定的难度。而类似乐泰UF3800及道尔DU986系列的粘度在200至400cps,由于流动性太强,估计难以上下两层都进行均匀填充。而目前的3536粘度大约为2000cps左右,介于两者之间,应该是比较适合POP底部填充的。这是当时在上海与客户直接交流的初步结论,但对于POP封装与传统BGA对underfill胶水有什么更多不同其实也不是太了解。其实如果据此简单推论的话,那么韩国元化学的WE-3008应该也能适用于POP的封装,因为其粘度也大约在2000cps左右,后来咨询了一下韩国元化学的金社长,果然他们的WE-3008在三星手机上面就有用于POP底部填充的。
其实后来思考了一下,其实粘度不应该是简单决定是否适合POP封装的必要条件,因为后面在电子胶水论坛网友讨论zymet公司的underfill时,其中有一段是这样写的“Zymet公司日前推出新的可维修的底部填充胶CN-1728,这一产品是专为POP工艺的组装而设计的。POP的底部填充胶工艺与BGA的工艺有相当大的不同,与以前的同类产品相比,CN-1728有更低的热澎涨系数和较高的玻璃转换温度(Tg),与助焊剂有更好的兼容性,这些都使其具有卓越的热循环性能表现。 CN-1728是具有快速流动的毛细管效应底部填充胶,其黏度为900 cps,可以在150 °C的温度下一分钟完成固化。这种特性使得CN-1728可以适应生产线上的高速大批量生产。 维修可以通过提高温度到170°C -180°C后,移除PoP周围的胶材。然后加热至焊锡熔融温度后移除BGA,再回到170°C -180°C,并轻易的去除剩余的胶材”,后来在网上找到了CN1728的TDS资料,其粘度只有900cps。所以当时在上海的结论也未必是正确的。
不过最终可以确认的一点是POP用的underfill与传统BGA下使用的underfill差异应该不是特别大,而且也远没有上升到一道underfill的要求(例如对填料里面的射线要求等),毕竟POP 也是将封装好的IC进行叠加,而不是直接用裸芯片进行叠加,底填材料不直接接触硅晶片,当然也不需要一道underfill那么高的要求了。另外关于POP封装的返修应该要比BGA返修更麻烦一些, 在网上找到了一份OKI返修台针对POP封装的返修指南,大家可以参考一下!
另外附上韩国元化学WE-3008及zymet公司CN1728及乐泰3536 TDS资料供大家参考:解压密码g4e
《【扒一扒】日本高纯球形硅微粉材料生产商》: 作为一种无机非金属矿物功能性粉体材料,硅微粉广泛应用于电子材料、电工绝缘材料、胶黏剂、特种陶瓷、精密铸造、油漆涂料、油墨、硅橡胶等领域。 目前,世界上只有中国、日本、韩国、美国等少数国家具备硅微粉生产能力... 全文 ?