1、二氧化硅层的用途:
a.表面钝化:保护器件的表面及内部、禁锢污染物在二氧化硅膜中;
b.掺杂阻挡层:掺杂物在二氧化硅的运行速度低于硅中的运行速度、二氧化硅的膨胀系数与硅接近;
c.表面绝缘体:氧化层必须足够厚,以免产生感应现象,称为场氧化物;
d.器件绝缘体:热生成的氧化层可以用来做硅表面和导电表面之间形成的电容所需的介电质;
e.器件氧化物的厚度与用途:
60—100埃 隧道栅极
150—500埃 栅极氧化、电容绝缘层
200—500埃 LOCOS氧化
2000—5000埃 掩膜氧化、表面钝化
3000—10000埃 场氧化
2、热氧化机制:阶梯式升温方法,900-1000℃之间
a.生长氧化层会经历两个阶段:线性阶段(<1000埃)和抛物线阶段;
受限反应(transport limited reaction)、受限扩散反应(diffusion limited reaction);
b.一个加速氧化方法是用水蒸气(H2O)来代替氧气做氧化剂,氢氧基离子扩散穿过晶圆上的氧化层的能力比氧气快;
蒸气氧化(steam oxidation)、湿氧化(wet oxidation)、高温蒸气氧化(pyrogenic steam); 全文 »
近日去宇龙公司探讨其UNDERFILL材料认证的事情,了解到其以前使用的为LOCTITE 3536 UNDERFILL材料,以前接触到在手机行业使用多的是loctite 3513型号,这款型号倒是首次看到有厂家在使用。后来查证了一下,此款产品是loctite公司在2007年初推出的一款新产品,可同时用于BGA及CSP封装下面。但是我去loctite官方网站(好像和HENKEL的已经合在一起了)却没有找到其TDS资料,MSDS资料也找不到,或许还没有在其官网上发布。后来通过google搜索了一下,也只找出来了一篇2007年2月汉高的一篇新闻稿关于3536的,还找了一篇乐泰公司的产品彩页中有相对比较详细的技术说明。技术参数大致摘录如下:
Loctite 3536 adhesive is a fast flow,low temperature cure,reworkable epoxy underfill for BGA and CSP devices.It exhibits high adhesion to flexible and rigid circuit substrates.Loctite 3536 adhesive,when fully cured,provides excellent protoction for the solder joints against induced stresses,increasing both the drop test and the temperature cycle performance of the device.
基本技术参数如图: 全文 »
1、各类胶粘剂的化学成分与力学性能(室温搭接剪切强度/MPa-psi)(剥离强度/Kn/m-piw):
压敏类 0.01-0.07(2-10) 0.18-0.88(1-5)
淀粉类 0.07-0.7(10-100) 0.18-0.88(1-5)
纤维素类 0.35-3.5(50-500) 0.18-1.8(1-10)
橡胶类 0.35-3.5(50-500) 1.8-7(10-40)
配方类热熔胶粘剂 0.35-4.8(50-700) 0.88-3.5(5-20)
合成类热熔胶粘剂 0.7-6.9(100-1000) 0.88-3.5(5-20)
PVAc乳液(白乳胶) 1.4-6.9(200-1000) 0.88-1.8(5-10)
氰基丙烯酸酯类 6.9-13.8(1000-2000) 0.18-3.5(1-20)
蛋白质类 6.9-13.8(1000-2000) 0.18-1.8(1-10)
厌氧丙烯酸类 6.9-13.8(1000-2000) 0.18-1.8(1-10)
橡胶改性丙烯酸类 13.8-24.1(2000-35000) 1.8-8.8(10-50)
改性酚醛树脂类 13.8-27.6(2000-4000) 3.6-7(20-40)
未改性环氧树脂类 10.3-27.6(1500-4000) 0.35-1.8(2-10)
双马来酰亚胺类 13.8-27.6(2000-4000) 0.18-3.5(1-20)
聚酰亚胺类 13.8-27.6(2000-4000) 0.18-0.88(1-5)
橡胶改性环氧树脂类 20.7-41.4(3000-6000) 4.4-14(25-80)
以上只是一个指南,并不是严格确定,而且相关强度还取决于被粘物的化学组成和厚度;
2、在使用载荷下各类胶粘剂的耐高温顺序:(依次递增)
非硅氧烷类压敏胶粘剂
淀粉类
配方类热熔胶粘剂
合成类热熔胶粘剂
橡胶类
纤维素类
PVAc乳液(白乳胶)
固化型热熔胶粘剂
氰基丙烯酸酯类
蛋白质类
聚氨酯类
橡胶改性丙烯酸类
厌氧丙烯酸类
橡胶改性环氧树脂类
未改性环氧树脂类
改性酚醛树脂类
硅氧烷类PSA
双马来酰亚胺类
聚酰亚胺类
以上是胶粘剂处于高温时的强度保持性(retention of strength),而不是在高温时的实际强度。
3、各类胶粘剂的固化及使用条件 全文 »
今日抽空在家看了此篇讲稿—《先進封裝與晶圓級封裝的基本原理》,是由飛信半導體股份有限公司研发处(International Semiconductor Technology Ltd. 東方技術學院)的杨智辉先生(Charles Yang)于2004年底撰写的,主要是针对CSP, WLP, Flip Chip, MCP/SiP& Lead Free等先进的封装方式的原理及相关应用做了全面的阐述,下面就摘录部分以及与电子胶水相关的部分与大家分享之:
与电子胶水相关内容:
■Why Underfill?
Theunderfillprotects the bumps from moisture or other environmental hazards, and provides additional mechanical strength to the assembly. However, its most important purpose is to compensate for any thermal expansion difference between the chip and the substrate.Underfillmechanically “locks together” chip and substrateso that differences in thermal expansion do not break or damage the electrical connection of the bumps
Underfillmay be needle-dispensed along the edges of each chip. It is drawn into theunder-chip space by capillary action, and heat-cured to form a permanent bond.
■Process Anisotropic Conductive Film (ACF) COG/ NCP Process Flow
Film →Pre-Laminate→Pre-Bonding→Final Bonding
■填膠技術(Underfilldispensing)
a.點膠機台加熱系統:溫度要穩定誤差小,溫度控制誤差±5℃以下。基板要平貼在加熱工作台上,使基板均勻受熱。膠量控制:要量化、有監控及校正系統且重現性佳。
b.加熱方式:加熱器數量,片狀或條狀均會影響溫度均勻度,工溫度誤差作台面±5℃以下。
c.點膠圖形:事先分析點膠路徑選擇一字形、L字形、U字形那一型最適合?
d.覆晶填膠製程在全部製程中速度最慢,因為膠材以毛細現象在微小間隙內流動,晶粒尺寸增加要維持良品率是很困難的亦即點膠時間和包覆氣泡的機率相對增加。
■各種流動模式流動分析
點膠品質會受到晶粒尺寸、凸塊排列以及密度、接點高度、工作溫度、基板影響,並且發揮膠材特性,另外構裝設計階段即將填膠工程一併考慮,方呈現良好的點膠品質。
■點膠機點膠閥比較 全文 »
第六章 工艺良品率
1、维持及提高良品率(yield)对半导体工业至关重要,三个主要的良品率被用来监控整个半导体工艺制程:
晶圆生产部门-良品率=晶圆产出数/晶圆投入数;
晶圆电测-良品率=合格芯片数/晶圆上的芯片总数;
封装-良品率=终测合格的封装芯片数/投入封装生产线的合格芯片数;
2、累积晶圆生产良品率:在晶圆完成所有的生产工艺后,第一个主要良品率被计算出来,称之为FAB良品率、生产线良品率、累积晶圆厂良品率或CUM良品率。要得到CUMl良品率,需要首先计算各制程站良品率(station yield=离开制程站晶圆数/ 进入制程站晶圆数),将各制程站良品率相乘即得整体的晶圆生产CUM良品率(典型值50%-90%)。
3、晶圆生产良品率的制约因素:
a.工艺制程步骤的数量;
工艺步骤增加,良率下降;工艺步骤增加同时提高了后四个制约良品率因素对制程中晶圆产生影响的可能性—数量专治。(对于商用半导体,75%的晶圆厂CUM良品率是赚取利润的底线,自动化生产线则要达到90%或以上)
b.晶圆破碎和弯曲;
手工和自动的操作、对晶圆的多次热处理、晶圆表面的平整性要求。 全文 »
1、热熔胶粘剂:
a. 热熔胶粘剂是一类在熔融条件下进行涂布,经硬化后和结晶产生强度的胶粘剂;
b. 热熔胶粘剂可分为两类:一类取决于配方设计,也就是说,其性能取决于各组分的配合,从何获得均衡的性能;另一类其性能主要来自于分子设计,即源于制备聚合物基体的单体的选择。
2、聚合物的物理特性和热熔胶粘剂:
a.区分热熔胶粘剂与其他胶粘剂的主要特征是:热熔胶粘剂是在熔融的情况下进行涂布,通过再凝固形成粘结强度的。对于热熔胶粘剂来说,熔融特性、熔融态的润湿性、再凝固性及凝固后的特性等都非常重要;
b.热熔胶粘剂的另一个重要的性能参数是熔融粘度,过高的熔融粘度会导致胶粘剂的涂布非常困难,此时一般需要采用专门的设备才能进行操作,熔融粘度取决于聚合物的分子量,因此聚合物的分子量应该低。作为热熔胶粘剂基体聚合物大多数是半结晶,而非无定形的;
c.热熔胶粘剂行业的熔融粘度一般用熔融流动指数(MFI)或熔融指数(MI)来表示,常用ASTMD1238方法来测试;
d.热熔胶粘剂对于表面的润湿能力不仅取决于润湿关系,而且还取决于胶粘剂处于熔融状态的时间;热熔胶粘剂的另一个问题是对高导热基材(如金属)的润湿,因为热熔胶粘剂中的热量很快会被基材散失掉,使得胶粘剂在润湿表面前就以及凝固了,一般用预热基材方式解决该问题。 全文 »
1、压敏胶粘剂(PSA-Pressure Sensitive Adhesive)的定义:
a. 粘性强力且持久;b.仅用指压即可粘附;c.不需要任何能量源来激活;
d. 具有足够的能力束缚被粘物;e.具有足够的内聚强度,使其能够从被粘物上干净的去除。
初粘性-tack 增粘剂-tackifier 压敏胶带-PSATs
2、PSAs基体树脂的化学性质:
a.天然橡胶基PSA:多用于PSAT中(覆膜胶带 masking tape),长期暴露环境中不稳定;
b.丙烯酸酯基PSA:2-乙基己基丙烯酸酯和丙烯酸异辛酯+丙烯酸,优异的的耐老化性能;
c.嵌段共聚物弹性体:通过相分离来满足PSA的要求,由异戊二烯或丁二烯与苯乙烯形成A-B-A嵌段共聚物可以产生相分离结构
d.硅氧烷类PSA:聚二甲基硅氧烷+二苯基硅氧烷单元经过增粘和交联;
e.聚异丁烯、聚乙烯醚和聚丁二烯也可用于制备PSAs。
3、增粘剂的化学性质
增粘剂是一类独特的物质,它们通常是一些低分子量树脂,但其玻璃化转变温度和软化温度通常远远高于室温。
a.天然产物类增粘剂:松香酸衍生物、α-蒎烯和β-蒎烯(萜烯);
b.石油类增粘剂:由石油裂解产物得到,广义上分为两类-芳香族树脂(香豆酮-茚树脂、芳香类石油树脂和热活化树脂)和脂肪类树脂(“C-5”树脂);
c.其它增粘剂:一类是专门用于硅氧烷PSAs的MQ树脂,一类是叔丁基酚醛树脂; 全文 »
今日与量子光电两位工程师探讨关于LED用导电银胶的相关知识其中一个涉及到纯银的导热系数问题,当时没有确切的概念,回头查了一下,应该是429W/m.K,顺便将其他一些常见材料的导热系数列举如下:
(热传导系数的定义为:每单位长度、每K,可以传送多少W的能量,单位为W/mK。其中“W”指热功率单位,“m”代表长度单位米,而“K”为绝对温度单位。该数值越大说明导热性能越好。)
导热率 W/(m*K)
金刚石 1300-2400
硅 611
银 429
铜 401
金 317
铍 250 全文 »
近日看了一篇论文《环氧树脂在电子封装中的应用及发展方向》,是《电子元件与材料》2003年第2期上面的一篇论文。总的来说是属于一篇入门级知识介绍的论文,主要也是以EMC中用到的环氧树脂材料为主,由于该文章的日期较早,所以在其介绍中例如阻燃剂的使用依然是溴化环氧树脂。其实无论是2005年开始提出的ROHS六项中的多溴联苯PBBs和多溴联苯醚PBDEs,还是08年开始提出的Halogen Free中要求的溴含量小于900ppm的限制,使用该类助燃剂的环氧树脂用于电子封装材料中只怕都是不再适合的,当然最新的技术表明低卤的封装材料也是可行的(但严格意义上的无卤几乎是不可能的,就如同国家对奶粉里面三聚氰胺的含量要求是小于2ppm一个道理),目前的一个主要问题可能还是成本和配套供应的问题,相信随着时间的推移都还是可以顺利解决的!
下面是该论文的简介和摘要,感兴趣的朋友可以下载附件查看一下全文:
环氧树脂在电子封装中的应用及发展方向
李晓云1,张之圣1,曹俊峰2
(1. 天津大学电信学院,天津 300072;2. 胜利油田胜建集团万方建材有限责任公司,山东 东营 257000)
摘要:介绍了环氧树脂在电子封装中的应用;环氧树脂的特点(收缩率小,耐热性好,密封性及电绝缘性优良,适用性好等)以及国外对其的技术改造(低粘度化,提高耐热性,降低吸水率)。
关键词:环氧树脂;封装材料;低粘度;耐热;耐湿
中图分类号: TQ323.5 文献标识码:A 文章编号:1001-2028(2003)02-0036-02
The Application of Epoxy Resin to the Electronic Encapsulation
LI Xiao-yun1, ZHANG Zhi-sheng1, CHAO Jun-feng2
(1. The School of Electronic Engineering, Tianjin University, Tainjin 300072, China; 2. Wangfang Building Material Ltd.,Co., Shengli Oil Field, Dongyin 257000, China)
Abstract: The application of epoxy resin to the electronic encapsulation is discussed. Epoxy resin is characterized with lesser shrinkage ratio, higher heat resistance, better sealing, higher insulation, better applicability, etc. The improvements abroad are reviewed, including lower viscosity, higher heat resistance and lower moisture absorbing ratio.
Key words: epoxy resin; material of encapsulation; low viscosity; heat-resistance; humidity-resistance
点击下载:














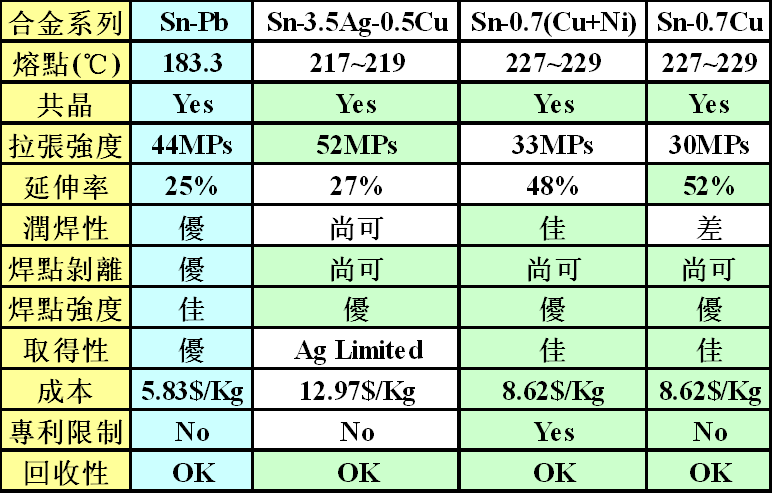



《【扒一扒】日本高纯球形硅微粉材料生产商》: 作为一种无机非金属矿物功能性粉体材料,硅微粉广泛应用于电子材料、电工绝缘材料、胶黏剂、特种陶瓷、精密铸造、油漆涂料、油墨、硅橡胶等领域。 目前,世界上只有中国、日本、韩国、美国等少数国家具备硅微粉生产能力... 全文 ?