不管是铝浆还是正银都是一种材料的具体形式,而材料本身的变化是无穷无尽的,只要搞清内部变化的原理,就会变化出各类奇妙功用的材料。而群里的讨论中往往缺乏一种对原理深入探讨,总是囿于一种产品级别秘密的发掘,发掘不出则冠之以基本到技术极限了,材料本身那有极限,有极限的只是个人思维理解的极限而已。 全文 »
由玻璃这个酸碱性我们来看看这个正银方面的一些问题。正银的玻璃体系是一直演变的,直到现在大家似乎大都认可了这个铅碲体系的妙用。而铝浆由于没有一个系统的演进过程及专利申请,因此无法看清玻璃演化路线,但从正银的玻璃体系演化来看,铝浆也将类似的出现大家都认可的一种玻璃体系的。 全文 »
对于Fsfac0047的应用扩散系数这个理论大家可以自己用“半导体金属化”“铝硅欧姆接触”及“铝硅合金结”做关键词搜索就明白这个应用的问题在那,在此不再分析。我随后将上传半导体金属化会议上一篇关于铝浆的论文(已翻译成中文),其对这个硅的迁移做了明确的电镜说明。 全文 »
按照金属化会议上发表的论文来说,硅和铝浆之间的作用是在300度左右就开始的,这个数据来自传统半导体金属化蒸镀铝的数据,但在太阳铝浆里应该没有的,这个你若300度下无论如何保温都不会看到铝浆和硅作用,因为此时的铝粉没有活性,不是蒸镀铝的活性。那么在577度铝硅合金的低共熔点有作用么,这个有的铝浆有有的没有,这取决于铝浆所用的玻璃,有的软化点高于577度,而大多是低于这个的。那么在高于铝粉670度这个点上那肯定是作用的,而且这个硅在铝中的扩散很快,几秒就可直达铝浆表面,同时这个硅在铝中的溶解度远远大于铝在硅中的,其极限浓度接近1.5%。而且按照金属化会议的结论,这个硅最易于在大颗粒铝粉的表面迁移。 全文 »
题目所述本质也仅指太阳能浆料现象的层面的本质探讨,非达浆料本身,也仅仅是一些推演,而非结论。
铝浆的龟裂纹从应用铝浆的开始阶段是没有的,是在05-06年前后儒兴的铝浆首先出现的。最开始是铅玻璃时代似乎都没龟纹,到后来无铅时代似乎大家都有了,但有铅的也能烧出龟纹。在这期间铝浆的烧结工艺随着正银的烧结不断变化,变化的似乎易于出现龟纹了,现在没有办法反过来用以前的烧结工艺再回头看看现在铝浆的体系是否有龟纹。总之,这个龟纹不同的玻璃粉有的有龟纹,有的没有, 全文 »
对于一个单一产品如此多的专利不断密集的申请,尤其是这个产品接近性能极限时,想起了情报大师伦纳德富尔德关于专利申请一个判断标准,那就是一个公司越是密集申请某个产品专利时往往意味着它内部已放弃这个产品而转型其它的了,而专利只是对竞争对手的一个误导。
对此我们应该有清醒的认识,因为毕竟正面的各类金属化技术都在活跃发展,电镀镍铜锡、喷墨银纳米墨水、烧结铜浆、埋栅的银纳米线等,而且电池本身的结构也在发生变化。 全文 »
国内的派系林立你无法准确的分出几类来的,不像国外就那么几家。因为国内不等你分完类这个类别里边的公司就已经变了,原来是这个类别的很快又变成另一个了,原来还有很快就又没有了。不管是那一类都有一个大梦想,那正银的天下……..
除了市场已有的这四大家及国内的各类派系,还有一些国外的大佬们虎视眈眈,图谋逐鹿。巴斯夫、庄信万丰、LG……
从没有一个单一浆料引起这么大重视,光看看专利库里面的专利就不知凡几,光杜邦一家就近百篇,看看国内传统浆料的专利加起来似乎有所不及,而且从那个技术内容来说更是如此。看看杜邦的专利就如同看元素周期表一样。 全文 »
铝浆在大家都还没怎么大讨论就已经实际大规模生产了,在这期间标准化的铝粉供应起到了技术扩散的作用。正银从开始除了杜邦是标准外国内没有任何标准的材料供应,于是大家热烈的讨论正银是从各类原材料开始的。记得开始最为大家津津乐道的就是那家银粉的振实密度超过5了,似乎超过了就是正银用的银粉了。似乎很快全国各地的银粉供应商各个大学研究报告都超过5了,晒出的电镜照片都是标准完美,似乎杜邦都有所不如。银粉有了,大家就开市讨论玻璃粉了,而去年横空出世的一款韩国玻璃粉(似乎专门为国内量身定做)使得大家都要赶超杜邦了。有机并没被大家怎么重视,因为没有掀起什么激烈大讨论,也许这个有机不管那一家都是自己合成的,其并没成为一个可销售的商品,所以也就没怎么讨论了,可实际大家的有机如何只有自己最清楚了。 全文 »
我这里所说的底部填充胶之测试技术主要是站在客户角度的,至于UNDERFILL研发过程中考虑的因素会更多一些,但与客户的实际评估又有着许多不同的地方,虽然某些指标和客户的测试技术是相关的,但实际中往往是综合因素的影响,所以要了解客户的核心需求才能对应提供合适的产品。另外在UNDERFILL的理论研究中(论文什么的)就考虑考虑得更细了,其中还用了很多数学、物理及化学的模型及函数来分析(中间还还涉及到表面张力、接触角,回归分析…),这个就更不在我们的讨论之列了。 全文 »
前面简介中以及提到过,UNDERFILL简单定义为“用于保护电子产品中某些芯片焊接后的锡球的一种胶粘剂”,所以理论上有锡球封装形式的电子元器件(BGA CSP FLIPCHIP……)等都可能使用到底部填充胶。而以上封装形式的元器件是为了迎合电子产品的轻薄小的需求而诞生的,而电子产品的轻薄小需求也是为了便于携带而诞生的。因为往往移动便携式电子产品中如果有用到有锡球封装形式的电子元器件时都有可能要用到底部填充胶水,这也是为什么上面讲胶水品牌时提到的都是智能手机厂商的使用。其实在其它一些领域也偶有底部填充胶的应用,但最终产品与手机的产量来说就望尘莫及了。所以这篇也是围绕常见的移动电子设备展开。 全文 »














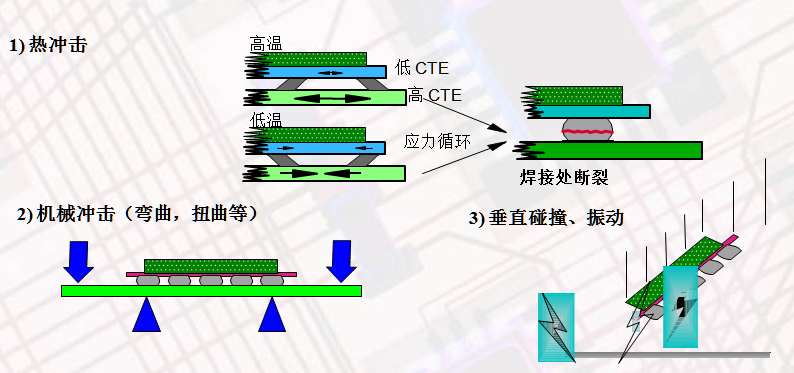



《【扒一扒】日本高纯球形硅微粉材料生产商》: 作为一种无机非金属矿物功能性粉体材料,硅微粉广泛应用于电子材料、电工绝缘材料、胶黏剂、特种陶瓷、精密铸造、油漆涂料、油墨、硅橡胶等领域。 目前,世界上只有中国、日本、韩国、美国等少数国家具备硅微粉生产能力... 全文 ?